详情
Lyncee Tec 4D反射测量仪
Characterize transparent patterns
Transparent pattern characterization by DHM® is a unique solution to measure 3D topography and thicknesses of transparent structures on a reflective substrate.
Measures topography, thickness and refractive indices of transparent structures
Measurement of surface structures from 10 nanometers to several microns
Measurement of refractive indices
Characterization of deposited or etched structures composed of up to 3 layers
Flexible instrument
Non-contact method, ideal to measure liquids and soft materials
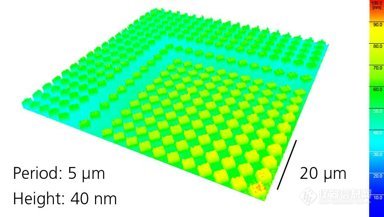 Typical transparent SiO2 pattern characterized by DHM reflectometry analysis
Typical transparent SiO2 pattern characterized by DHM reflectometry analysis
The 3D topography as well as the thicknesses and refractive indices of patterned transparent samples are retrieved by a dedicated post-analysis software by computing the complete reflected wavefront based on the laws of physics. Therefore DHM® provides a solution to measure the correct topography while measurements with alternative optical profilometer are affected by the multiple reflections of the light signal occurring in transparent materials.
Structures of Transparent materials such SiO2 and thin metal layers, widely used in coating, isolating, protective or structuring layers in semiconductor and MEMS industries, are typical samples easily characterized by DHM®.
Dynamical topography of liquids on microfluidics devices and on functional surfaces is critical to characterize because of multiple interferences occurring between the liquid and the substrate. DHM® with the Reflectometry analysis software enables to provide accurate dynamical measurements.
This solution encompasses a holographic microscope instrument by Lyncée Tec with a full range of microscope objectives, the dedicated Koala acquisition and analysis software and the dedicated Reflectometry post-analysis software.
Benefits
DHM® technology and its dedicated Reflectometry post-analysis software offer significant benefits.
Be innovative by extending your range of measurable samples
Perform Reflectometry analysis with a single DHM® instrument
Measure the topography on coated materials with metrological precision
Study surface topography of semiconductors with photoresist
Study dynamical dielectric constant variation (Hall effect)
Measure the 3D topography of liquids and soft materials
Get instantaneous results
Combien DHM® Reflectometry analysis software with live profilometry, stroboscopic synchronization and industrial solutions
Application Cases
In 2009, on request of a DHM® user measuring SIMS, Lyncée Tec has developed the solution to interpret optical measurement of samples with transparent structures. Since then, the Reflectometry analysis software has been continuously improved with new features and tools. Among many samples, Lyncée Tec has published the comparative measurements of geometrical topography for the following sample configurations:
SiO2 staircase on Si wafer
Height measurement of transparent multi-layered steps
Non-contact and complete 3D topography without any scanning
Step edges precisely highlighted
Crater dug through layers of Au-SiO2-Si
Depth measurement of a crater dug through transparent multi-layers on reflective substrate
Complete 3D topography of relatively large crater area
Depth determination with subnanometric vertical resolution
Fluid topography on substrate
Topography measurement of Liquid (TetraEthylenGlycol, TEG) drop on Si substrate
Non-contact, i.e. non damaging measure
Unique solution for complete 3D characterization of liquid or soft material drop
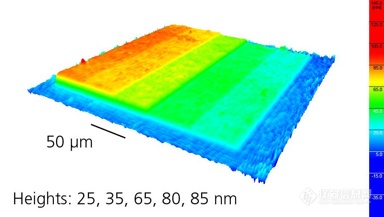 SiO2 Nano-staires on Si substrate
SiO2 Nano-staires on Si substrate
Publications
“Digital Holographic Reflectometry for Semi-Transparent Multilayers Measurement“, T. Colomb & al.
“Réfléctométrie Holographique Numérique Appliquée à la Métrologie des Fluides“, T. Colomb & al.
“Digital Holographic Reflectometry“, T. Colomb & al.




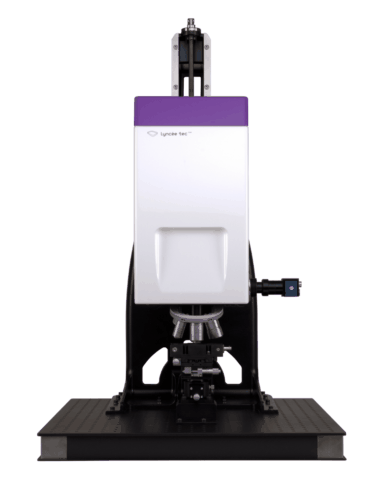









 陈谷一
陈谷一